来源:公众号:光学与半导体综研
半导体产业链
半导体产业链的上游是软硬件材料及设备,中游是集成电路的设计、生产,下游是终端产品应用。半导体产业链中游包括设计、制造和封测三大环节。封测是产业链中游的最后一个环节,芯片经过封测之后交付给芯片设计厂,再销售给下游终端产品应用企业。

从半导体设备产业链来看,半导体设备产业链上游主要为零部件及系统,零部件主要包括轴承、传感器、反应腔喷淋头、射频发生器、石英、机械臂、泵等;核心子系统主要包括气液流量控制系统、真空系统、制程诊断系统、光学系统、热管理系统、集成系统等。产业链中游主要为半导体设备,主要包括光刻机、刻蚀机、清洗设备、量测设备、分选机等。产业链下游主要为半导体制造,企业主要包括华润微电子、士兰微、通富微电、水晶光电等。

半导体设备
根据用于工艺流程的不同,半导体设备通常分为制造设备(前道设备)和封测设备(后道设备)。前道设备主要包括光刻机、刻蚀机、薄膜沉积设备、CMP设备、清洗设备、离子注入机设备、热处理设备等。后道设备主要分为封装设备和测试设备,封装设备主要包括划片机、贴片机、裂片机、引线键合机、切筋成型机等,测试设备主要包括分选机、测试机、探针台等。


前道晶圆制程工序:
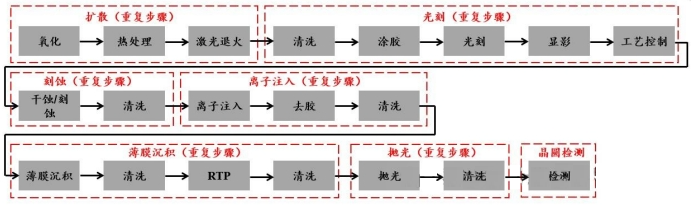
半导体设备价值占比:


半导体封测
封测是封装测试的简称,包括封装和测试两个环节。其中,封装是指将生产加工后的晶圆进行切割、焊线塑封,并加工为成品芯片的过程,测试则是指利用专业设备对产品进行功能和性能测试。
封装:指用特定材料、工艺技术对芯片进行安放、固定、密封,并将芯片上的接点连接到封装外壳上的工艺流程,其可保护芯片性能并实现芯片内部功能的外部延伸。基本的封装工艺流程包括:晶圆减薄(wafer grinding)、晶圆切割(wafer Saw)、芯片贴装(Die Attach)、焊接键合、塑封工艺、后固化工艺、测试、打标工艺(电镀、打弯、激光打印)、包装、仓检、出货等工序。
半导体封装工艺流程图:

测试:指对芯片产品的性能和功能进行测试,并挑选出功能、性能不符合要求的产品。测试主要分为封装之前的晶圆测试(Chip Probing)和封装之后的芯片成品测试(Final Test)。测试在确保芯片良率、控制成本、指导芯片设计和工艺改进等方面起着至关重要的作用。




厂家布局







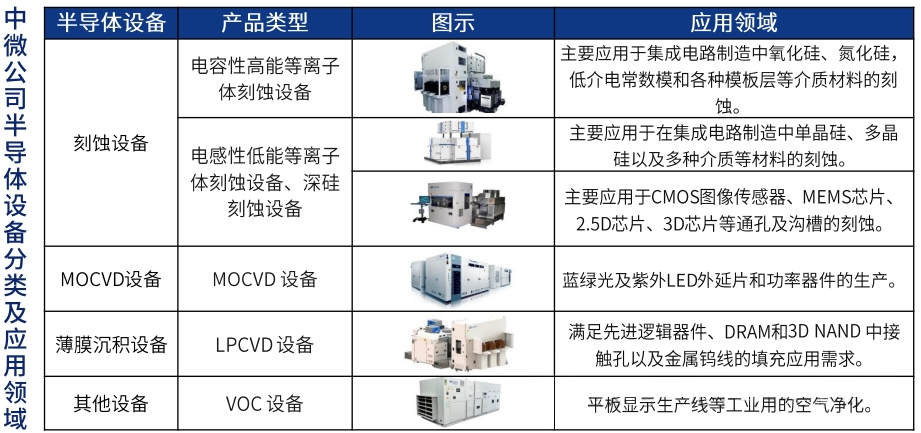

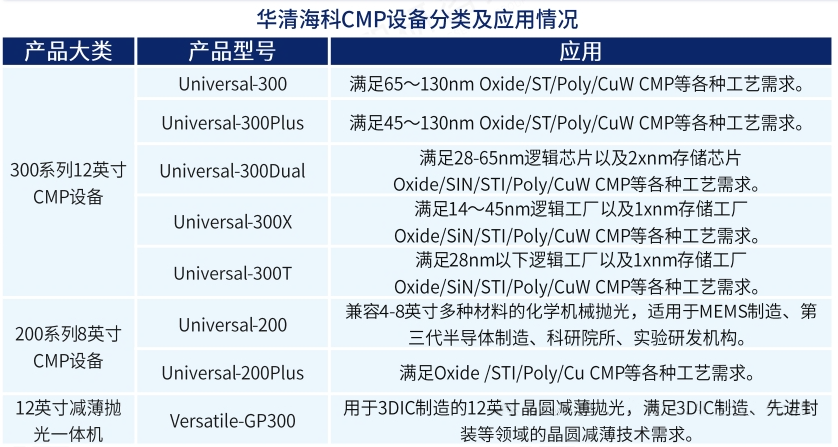
免责声明:本文系网络转载或改编,版权归原作者所有。文章内容系作者个人观点,转载仅为了传达一种不同的观点,不代表公司对该观点赞同或支持,如果有任何异议,欢迎联系我们。