来源:公众号:光学与半导体综研
极紫外光谱/软X射线电磁辐射谱是指波长为5~30nm的波谱。与曝光波长为248nm和193nm的深紫外(DUV)光刻类似,EUV光刻也使用投影物镜对掩模进行缩小成像。由于EUV光刻的曝光波长短,其分辨率明显高于DUV光刻。从DUV波段光学光刻到EUV光刻有几个重要变化:1、需要输出功率高、寿命长且稳定的光源。业内已开发了多种激光等离子体或放电等离子体光源。2、由于缺乏在EUV波段透过率足够高的光学材料,照明/投影光学系统不能采用传统的透射式透镜,必须替换为反射式光学元件,对掩模和EUV光刻系统的成像特性产生了重要影响。3、需要高灵敏度、高分辨率的光刻胶材料。高能EUV光子改变了入射光与光刻胶相互作用的方式。光子噪声、二次电子散射效应和其他现象都会影响光刻胶的灵敏度,分辨率和线边粗糙度。
EUV光刻系统的曝光波长取决于光源与材料,目前使用的波长为13.5nm。下图为极紫外投影光刻系统的原理图。收集镜将激光等离子体辐射出的EUV光聚焦到中继焦点上。照明系统采用四面反射镜对EUV光进行整形,并照明掩模台上的反射式掩模。投影物镜系统由6面反射镜组成,将掩模4X缩小成像至硅片上的光刻胶内。因为所有材料对13.5nm光的透射率都不足,所以系统需要运行在真空环境中。

本文重点介绍EUV光源、多层膜反射镜以及高数值孔径光刻。多层膜反射镜是极紫外光刻掩模和成像系统的重要组成部分,以反射式掩模和反射镜取代透射式掩模和透镜,对掩模和成像产生了重要影响。
光源
首次EUV光刻实验使用了同步加速器自由电子激光。由于功率低且成本高,这种同步加速器光源不适用于大规模量产。等离子体中的高能电子态也可以产生EUV辐射。可利用氙、锡、锂等靶材形成等离子体。放电等离子体光源和激光等离子体光源都曾被用于EUV光刻。转换效率(在窄波长范围内EUV光的功率与输入的电或光功率的比值)取决于靶材、靶的形状以及等离子密度等参数,为达到2%~5%的转换效率,较新的一些光源系统普遍使用锡作为靶材。下图为放电等离子体(DPP)光源和激光等离子体(LPP)光源示意图。通过进料口或激光烧蚀技术,将靶材从锡阴极输送到DPP的阴极和阳极之间。通过放电(DPP)或高功率CO2激光器(LPP)产生等离子体。出射的EUV光的峰值波长为13.5nm。等离子体也会产生带外(OOB)EUV辐射,以及紫外光和可见光。采用薄膜、多层膜反射镜或特殊光栅等光谱纯化滤波器可减少进入照明系统的带外辐射。DPP和LPP光源都会产生颗粒/微液滴、离子以及电子等高速运动的碎屑。这些碎屑可能会损坏照明和投影系统的光学元件。箔片陷阱可消除或者减少光路中的碎屑。多层膜或掠入射收集镜将除污之后的EUV光反射到光源与照明系统之间的中继焦点。DPP和 LPP光源的转换效率低,说明大部分输入功率转换为了带外辐射、碎屑和热损耗,所以会产生高热负载。如何有效处理热负载成为这两种EUV光源共同面临的挑战。碎屑会对反射镜以及等离子体周围的其他光源模块造成损伤,严重影响极紫外光源的寿命与稳定性。转换效率、光谱滤波器、碎屑缓减系统以及高热负载处理方法制约了EUV光源的输出功率。另一方面,产率指标要求中继焦点的输出功率最低要达到200W。输出功率的稳定性与光源的寿命也是EUV光源研发面临的挑战。上述问题以及光源性能的不足,使得 EUV 光刻技术应用于半导体制造的时间推迟了很多年。
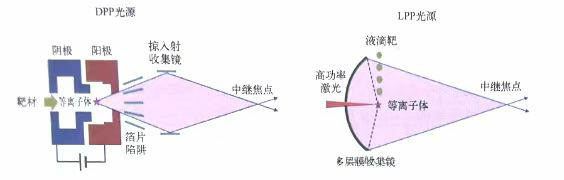
极紫外光刻机采用了LPP光源和预脉冲技术,如图所示。预脉冲(PP)的作用是增大锡液滴的体积,改善锡液滴与主脉冲(MP)的相互作用效果。完美的时空同步以及预脉冲技术显著提高了转换效率,使得EUV光源的输出功率超过了 250W。预脉冲技术是将EUV光刻技术推向半导体制造过程中的重要一步。除了上述两种光源之外,还存在自由电子激光和共振高次谐波激光等其他类型的EUV光源。自由电子激光未来有可能用作EUV光刻光源。高次谐波激光可用于EUV计量。
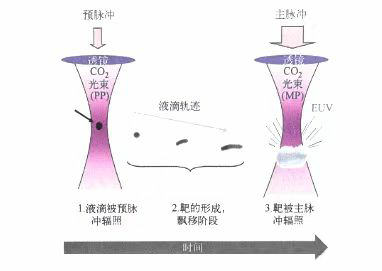
多层膜反射系统
所有EUV光谱范围内的材料都具有相似的光学性质,都会吸收EUV光,限制了元件对EUV光的操控能力。在极紫外光谱范围内无法使用类似透镜的折射元件。透射光栅、波带片或针孔等衍射元件的衍射效率低,虽然无法应用于高产率光刻成像系统,但可用于计量和一些特殊的应用场合。为实现高反射率,需要采用大的入射角(掠入射反射镜)或者能够使来自反射元件不同界面(多层膜反射镜)的反射光发生相长干涉。EUV成像光学系统和掩模采用多层膜结构。该多层膜由双层膜周期性地堆叠而成,如下图所示。
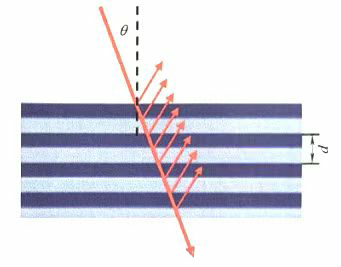
布拉格定理给出了不同界面的反射光发生相长干涉需要满足的条件:

式中d为双层膜的厚度,λ为波长,m为整数。所需双层膜的数量与可实现的反射率值取决于双层膜两种材料折射率实部之间的差异。为了使两种材料的光学性质差异足够大,双层膜常采用具有高低两种原子序数的材料。选择材料时还需要考虑含突变界面连续薄膜的制造能力等其他方面的技术要求。目前的掩模中使用了40对钼(Mo)和硅(Si)组成的双层膜。这些材料之间的折射率对比度很高,而且它们对EUV光的吸收相对较小。可以用传递矩阵法计算Mo/Si多层膜的反射率,下图显示了典型Mo/Si多层膜的反射率值随波长和入射角的变化曲线。在工作波长13.5nm处、0°~12°入射角范围内,理论反射率可达70%左右。图中,虚线和右图无阴影区域表示标称波长、入射角,以及与数值孔径0.33相对应的人射角范围。

吸收层位于Mo/Si多层膜上面,主要作用是产生EUV光刻掩模图形。入射角为6°的倾斜照明将反射光与入射光分开。多层膜反射率随入射角和斜射照明的变化而变化,导致了几种EUV光刻特有的成像现象。下图是典型EUV光刻掩模的横截面图。在热膨胀性超低的基底上沉积了40对 Mo/Si 双层膜。为了在一定入射角范围内获得高反射率,需要对Mo和Si层的厚度进行优化。钌顶盖层的厚度为几纳米,可使多层膜免受氧化以及其他物理和化学作用的影响。吸收层的作用是产生不透光的图形,通常由一种或多种材料组成。顶部吸收层的化学成分取决于吸收层沉积工艺,以及吸收层与局部环境的相互作用。吸收层膜层需要能够抑制极紫外光的反射,并便于利用深紫外光对掩模进行计量和检测。
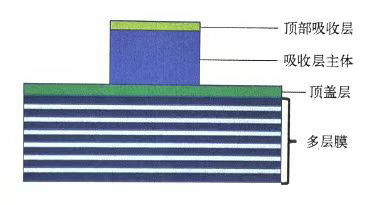
下图展示了光经过EUV掩模的衍射过程。图中给出了各个衍射级穿过掩模传播的光路。吸收层和多层膜反射镜都被简化为无限薄的光学元件。通过设定吸收层和多层膜之间的距离,将多层膜简化为位于真实多层膜内的一个反射面。光源发出的光向下传播,照射到吸收层后发生衍射,形成离散的衍射级次。衍射光照射到多层膜上,所有级次都被反射回吸收层。向上传播的级次再一次照射到吸收层发生衍射。吸收层顶部向上传播的光包含两套衍射级,代表光的两次衍射。-3/+3、-2/+2、-1/+1、0/0、+1/-1…级衍射光相干叠加产生了光瞳内的0级衍射级。这些衍射级的强度不同,在吸收层和(多层)反射镜之间传播时产生的相位延迟也不同。投影物镜光瞳内的其他衍射级次也类似。二次衍射以及吸收层和多层膜有效反射面之间传播距离和相位延迟的不同导致EUV光刻具有一些DUV光刻所没有的特殊成像效应。

EUV高数值孔径光刻工艺
EUV光刻采用了反射式投影系统设计,需要平衡成像质量和光强传输效率。每个多层膜反射镜只能反射约65%的入射光。增加反射镜数量会引入更多的优化自由度,有利于提高成像质量,但会降低系统的光强传输效率。当前,NA为0.33的系统使用了六面反射镜。下图为EUV 投影系统的设计示例。可以看到增大NA对硅片面的影响。NA增加后需要一面更大的(最后一面)反射镜。左侧和中间所示的小NA系统中,倒数第二面反射镜向外向右倾斜,最后一面反射镜被倒数第二面反射镜照明。进一步增加倾斜度将导致光在最后一面反射镜上的人射角范围过大,反射率损失严重。
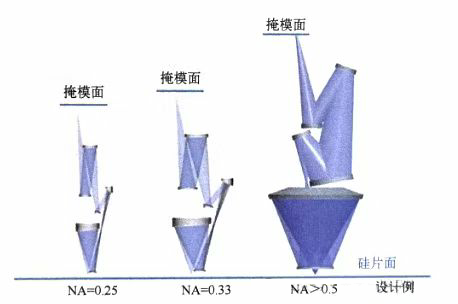
因此,高NA系统的倒数第二面反射镜没有倾斜,而是采取了在最后两面反射镜上钻孔的方案。这些孔在投影光瞳的中心产生一个暗区或遮拦。中心遮拦仅占光瞳面积的4%~6%,实际应用时不会对成像性能造成明显影响。下图显示了增大4x缩小成像系统的N给掩模面带来的影响。掩模/照明面的数值孔径定义为NA(illu)=NA/M,其中M是投影系统的放大(缩小)倍数,通常为4。如左图所示,NA=0.33的系统中,在物方入射角为主光线角(CRAO=6°)的倾斜照明条件下,入射光与掩模反射光可以分开。对于给定系统,增加NA将导致入射光锥和反射光锥发生明显重叠。采用这种结构无法将入射光和反射光分开。
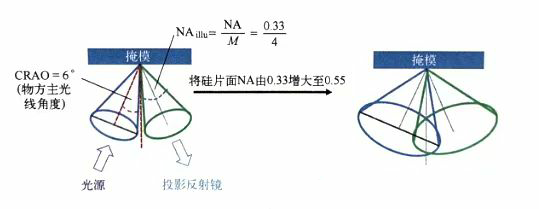
解决该问题的第一个方法是将CRAO增加到9°左右。较大的CRAO和反射式掩模增大了高NA EUV投影系统的复杂度。如下图所示,当入射角在投影物镜光瞳面上接近右边缘时,多层膜反射率明显下降。在这样的入射角下,多层膜反射率的降低导致的对比度损失过大,特别是对于水平方向密集图形。改变缩小倍率是避免高数值孔径EUV系统中入射光和反射光发生重叠的方案。下图的中图和右图为改变缩小倍率之后的系统。中图为x和y方向缩小倍率都为8(8x/8x)的系统及其相应反射率图。右图为非扫描方向和扫描方向缩小倍率分别为4和8(4x/8x)的组合倍率系统及其相应反射率图。两种系统在主光线倾斜方向上的缩小倍率都更大。在有效入射角范围内,掩模多层膜的反射率几乎相同。沿x轴(垂直于主光线的倾斜方向)的缩小倍率变化对光瞳内的多层膜反射率几乎没有影响。
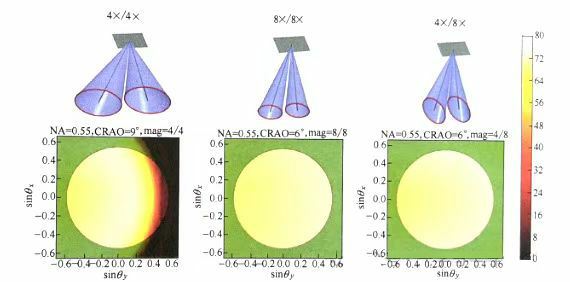
组合倍率投影物镜的应用对照明系统和掩模都产生了重要影响。在x和y方向上,照明系统和掩模的形状都必须按给定的比例进行缩放。如下图所示,物方椭圆形照明光瞳在像方转换为圆形光瞳。组合倍率照明可以由非对称场镜和相应的非对称瞳镜产生。

下图为掩模图形从物方到像方的变化示意图。实际中需要根据物方拉伸后的图形制作掩模。由于线宽较小,垂直图形(沿y方向)对掩模形貌效应更敏感。
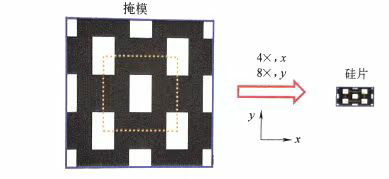
高NA系统出射光线的角度更大(像面),对偏振效应更敏感。EUV光刻等离子体光源的出射光是非偏振光。非偏振光照明条件下的成像对比度比优化后偏振光照明条件下的成像对比度低。DUV光刻中光在空气/水/光刻胶界面处的折射降低了偏振对成像的影响。不同于DUV光刻,EUV光在真空和光刻胶(折射率非常接近1)内的偏振效应几乎相同。EUV光与多层膜光学元件、掩模之间的相互作用会产生额外的偏振效应。理解与处理相关效应对推动高NA EUV光刻技术向其极限发展非常重要。
免责声明:本文系网络转载或改编,版权归原作者所有。文章内容系作者个人观点,转载仅为了传达一种不同的观点,不代表公司对该观点赞同或支持,如果有任何异议,欢迎联系我们。